WTIは持続可能な開発をサポートします
2021年06月15日 みなさん、こんにちは! 第一技術部光デバイス設計課の鳳山です。
みなさん、こんにちは! 第一技術部光デバイス設計課の鳳山です。
入社一年目のときに投稿して以来、約3年ぶりの投稿です。
私は、お客様の事業場所に駐在し、お客様と共に業務を遂行するエンジニアリング部門に所属しています。主に半導体デバイスの開発設計業務に従事しており、お客様と共に開発品の特性評価や信頼性検証などを実施しています。(WTIの技術紹介パンフレット一覧はこちら)
 みなさん、こんにちは! 第一技術部光デバイス設計課の鳳山です。
みなさん、こんにちは! 第一技術部光デバイス設計課の鳳山です。
入社一年目のときに投稿して以来、約3年ぶりの投稿です。
私は、お客様の事業場所に駐在し、お客様と共に業務を遂行するエンジニアリング部門に所属しています。主に半導体デバイスの開発設計業務に従事しており、お客様と共に開発品の特性評価や信頼性検証などを実施しています。(WTIの技術紹介パンフレット一覧はこちら)

当社は、設計専門会社として回路設計から構造設計までワンストップで製品の開発設計を行っております。WTIの基板のレイアウト設計では、この利点を活かし社内技術部門(デジタル、アナログ、高周波、電源、熱/応力、筐体)とも連携し、電気的な視点、構造的な視点を考慮した設計を行えることが特長です。
また、大学や研究機関向けにベアチップを用いたCOB(Chip on Board)の基板設計、BGAパッケージ設計などの特殊基板の少量試作サービスも行っております。
- 回路的視点、構造的視点に基づく小型、高密度実装の基板設計
- 熱解析、応力解析と連携した基板設計
- アナログ/デジタル回路、高周波・無線回路、電源回路、高速信号回路の基板設計
- お客様のご要求に応じ、SI(Signal Integrity)/PI(Power Integrity)/EMIの電気解析を反映した基板設計が可能
- 紙ベースの回路図は回路図CADにて再トレースも可能
- 通常のリジット基板以外にフレキシブル基板、アルミ基板などの特殊基板の設計/試作対応が可能
- 試作(基板製作、部品実装)は弊社が協力会社と連携し、短納期にて対応
(お客様は基板仕様の調整や実装指示などの手間が省けます。)
回路図CAD OrCADCaputre(Cadence) CR8000 Design Gateway(図研) 基板設計CAD CR8000 Design Force(図研) CR5000 Board Designer(図研)
| 基板名 | 概要 | 特徴 | 部品点数 基板仕様 |
| ウェアラブル 端末用基板 |
|
小型化、高密度 アンテナ 社内技術連携 |
約120点 4層ビルド |
| LANユニット 基板 |
|
大規模回路 高密度、高速信号 電気解析 |
約2180点 12層貫通 |
| 制御装置基板 |
|
大規模回路 大電流、大型基板 社内技術連携 |
約4090点 6層貫通 |
| GNSS通信 基板 |
|
アンテナ、高密度 高速信号 |
約400点 6層貫通 |
| センサ/無線 通信端末 |
|
小型化、アンテナ 社内技術連携 |
約210点 4層貫通 |
| 据え置き型 無線通信基板 |
|
小型化、高密度 アンテナ |
約1300点 6層貫通 |
| 高周波基板 |
|
高周波 社内技術連携 |
約250点 2層貫通 |
| 電源基板 |
|
高電圧、大電流 社内技術連携 |
約370点 4層貫通 |
| GPSモジュール基板 |
|
小型化、高密度 アンテナ 社内技術連携 |
約80点 4層ビルド |
| Zigbee モジュール基板 |
|
小型化、アンテナ高密度、特殊基板社内技術連携 | 約40点 2層貫通 |
| リモコン用 基板 |
|
小型化、アンテナ 高密度、特殊基板 |
約80点 4層ビルド |
| 操作装置基板 |
|
基板間干渉 | 約320点 4層貫通 |
| 通信機器基板 |
|
小型化、高密度 アンテナ、熱 |
約1050点 6層貫通 |
| Ethernet基板 |
|
高速信号、 電気解析、熱 社内技術連携 |
約530点 8層貫通 |
| インバータ用 基板 |
|
高電圧、大電流 | 約580点 8層貫通 |
| BGAモジュール基板 |
|
小型化、高密度 高速信号 特殊基板 |
約30点 10層ビルド |
| 半導体PKG 評価用基板 |
|
仕様検討 社内技術連携 |
約30点 2層貫通 |
| LEDフレキ基板 |
|
特殊基板 | 約3030点 2層フレキ |
| アンテナ モジュール基板 |
|
アンテナ 特殊基板 |
搭載部品なし 2層貫通 |
| EOL対応基板_事例1 |
|
維持設計 | 約480点 2層貫通 |
| EOL対応基板_事例2 |
|
小型化、低コスト | 約280点 2層貫通 |
① 熱解析を反映した設計事例
~熱解析の活用で、熱対策と基板制約を最適化~
近年の電子部品の小型化や高機能化に伴い、電子部品単体だけではなく、実装基板を含めた、熱設計が重要となっています。
熱解析(シミュレーション)を活用することで、熱対策を反映した基板設計が可能です。【部品の発熱イメージ】
実装基板上の発熱部品(電源IC)を想定した熱シミュレーション結果
温度分布
熱流束分布(熱の流れ)
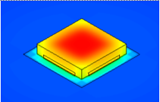 via数:0本 |
 via数:4本 |
 via数:16本 |
 |
大半は実装基板へ熱が伝わるため、実装基板での対策が効果的
パッケージ下のサーマルビアは、熱対策に効果大
部品下のvia 数のPKG 表面温度分布
部品下にviaを設けることで対策が可能ですが、部品形状や消費電力により、効果が変わります。
実装基板の設計制約(実装密度など)とトレードオフの関係があるため、熱解析を活用することで、最適な設計が可能です。また、周辺部品への熱温度分布の確認も可能です。
② 熱応力解析を反映した設計事例
~3Dモデルの非線形有限要素法シミュレーションを用いた
ランド径の最適化設計により、長寿命化のボトルネックを解消~電子機器の小型化に伴い、BGAなど小型部品の採用機会が増え、実装信頼性の重要度が増してきております。
特にBGAでは温度サイクルなどの熱衝撃に対して、部品側のランド形状や実装基板側のランド形状のバランスが悪いと、実装信頼性が低下します。(熱衝撃で半田ボール部にクラックが発生します)
基板設計時に応力シミュレーションを活用することで、実装信頼性を考慮した基板設計(ランド設計)を行います。
実装基板上のICパッケージ(BGA)を想定した構造シミュレーション結果
- 大学や研究機関向けにベアチップを用いたCOB(Chip on Board)の基板設計、BGAパッケージ設計や少量試作サービスを行っております。
- ご要求仕様を満足するよう、ベアチップのパッド配置のご提案や試作協力会社と連携し、ワイヤリング/基板設計、及び、試作製造を行います。
- チップ研磨、チップ積層、ポッティング、COB/SMT部品混在の試作が可能です。
- 簡単な接続仕様やポンチ絵からの回路設計/回路図作成も実施します。
【3段積層】 【異なるチップサイズの積層】
【チップオーバーハング実装】 【BGAパッケージ設計】
【関連リンク】
 皆様、初めまして。入社4年目、第一技術部 高周波機器設計課の北林と申します。
皆様、初めまして。入社4年目、第一技術部 高周波機器設計課の北林と申します。
よろしくお願いいたします。
私が担当する業務のひとつに、EOL対策(生産中止となる電子部品の代替品調査や置き換え)があります。
EOLになる部品の種類はさまざまで、用途に適した部品を選ぶには電子部品ごとの特徴を詳しく理解することが重要になってきます。私自身もまだまだ知らないことが多く、日々知見を深めながら対応を進めています。
今回は、デジタル回路には欠かせないクロックを生成する「水晶」を例にとって説明したいと思います。
(当社のEOL対応(生産中止・ディスコン)はこちら)
 みなさんこんにちは。システム設計課の尾崎です。
みなさんこんにちは。システム設計課の尾崎です。
WTIでは日本国内における電波法の技術基準適合証明(いわゆる技適)および工事設計認証の代行サービスを行っておりますが、今回は最近問合せが増えてきたUWB(超広帯域無線システム Ultra Wide Band)の認証についてお話しします。
(当社の技適代行サービスはこちら)
 みなさんこんにちは。システム設計課の寺藤です。
みなさんこんにちは。システム設計課の寺藤です。
みなさんが信号波形を観測する際、多くの場合はオシロスコープを使用されると思います。今日はそのオシロスコープで見ている波形は本当に正しいのか?ということについてお話しします。
(当社の電気設計受託サービスはこちら)
まず始めにオシロスコープ本体についてです。
 みなさんこんにちは、第一技術部 高周波デバイス設計課の北村です。
みなさんこんにちは、第一技術部 高周波デバイス設計課の北村です。
(WTIの高周波(RF)・無線 設計受託はコチラ)
高周波デバイス設計課では、増幅素子をはじめとした、高周波で使われる半導体デバイスを扱っています。製品開発の過程では、ウエハの状態で高周波特性を測定する「オンウエハ評価」を行うこともあります。私はこれまでこのオンウエハ評価に携わってきました。この業務において、初めてオンウエハ評価を行う方が「難しい」と感じることが多いのが、RFプローブの取り扱いです。今回はこのRFプローブの取り扱いについてお話しさせていただきます。