温度サイクル試験の寿命予測・改善
【目次】
| 製品の温度サイクル試験の問題で対策に追われていませんか? パッケージ構造を考慮したシミュレーション結果のご提供により、温度サイクル試験の寿命を改善し、不要な評価のコスト削減や寿命改善に向けた対策をサポートします。 |
電子機器の信頼性確保
電子機器の市場動向は小型化・高密度化を求めており、その一方で信頼性(寿命,温度領域等)には、高いスペックを求められるケースが急増しています。車両用電子機器や屋外設置用機器は、夏の炎天下から寒冷地までさまざまな温度条件への適合性が求められます。また、屋内機器であっても、低温環境から高温環境まで機器の設置環境ごとの温度条件への適合性が求められます。そのため、厳しい温度変化に対する長期的な信頼性の確保が更に重要となってきています。
熱疲労による破壊モード
実使用環境下におけるはんだ接合部の問題の一つが、熱に基因する熱疲労破壊です。電子部品と基板は多くの場合、線膨張係数が異なるため、電子部品の自己発熱や外部からの輻射熱などによる温度変化が発生すると部材間に熱膨張差が生じ、構造強度上最も弱いはんだ接合部周辺に応力が集中します。この温度変化の繰り返しによって、はんだ接合部や配線パターンに熱疲労によるクラックが発生し、最終的に破断・断線に至ります。
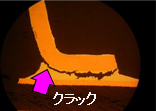 QFP
QFP |
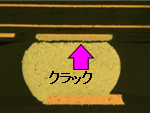 BGA
BGA |
|
はんだ接合部の断面研磨写真(温度サイクル試験の不良品) |
|
電子機器内の基板には、大小さまざまな電子部品や半導体デバイスが実装されています。その中で電子機器の高性能化(小型化)に向けて、使用する電子部品は変化していきますが、新しい電子部品に対する設計ルールがない場合があります。
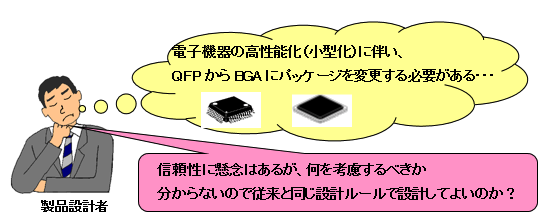
BGA(Ball Grid Array) やCSP(Chip Size Package)などのパッケージは、QFP(Quad Flat Package)などの従来のパッケージに比べると、リード部による応力緩和が期待できないため、パッケージと実装する基板との熱膨張差の影響が大きくなり、信頼性の確保が難しいパッケージ構造となります。
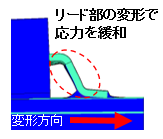 QFP(リード部) 続きを読む |









 みなさん、明けましておめでとうございます。
みなさん、明けましておめでとうございます。 お客様から当社にお問合せをいただく内容の中には、お客様が他の設計会社様に設計を委託され、その設計結果が思わしくなかったことから、当社に「見ていただけませんか?」と、ご依頼を受けるものがあります。
このようなお問合せをいただくたびに、私どもは本当に光栄に感じます。
お客様から当社にお問合せをいただく内容の中には、お客様が他の設計会社様に設計を委託され、その設計結果が思わしくなかったことから、当社に「見ていただけませんか?」と、ご依頼を受けるものがあります。
このようなお問合せをいただくたびに、私どもは本当に光栄に感じます。  2007年に日本で生まれた人の半分は107年以上生きると予想される
2007年に日本で生まれた人の半分は107年以上生きると予想される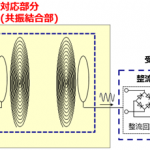 前回、「新ものづくり新サービス展」に出展したことをお話させていただきました。
前回、「新ものづくり新サービス展」に出展したことをお話させていただきました。 インテック大阪で本日から3日間、「新ものづくり新サービス展」に当社WTIが出展しています。
無線電力伝送(ワイヤレス給電)のデモ機を2機と、防水試験やEMI対策のパネルを出しますので、ご興味とお時間のある方は是非ご来場ください。
インテック大阪で本日から3日間、「新ものづくり新サービス展」に当社WTIが出展しています。
無線電力伝送(ワイヤレス給電)のデモ機を2機と、防水試験やEMI対策のパネルを出しますので、ご興味とお時間のある方は是非ご来場ください。 
 「IoT製品をこれから開発したいけど、人も技術も不足している」とお感じの企業様を対象に、IoT技術のプロフェッショナルをお客様企業内に作り出すプロジェクトを開始します。
「IoT製品をこれから開発したいけど、人も技術も不足している」とお感じの企業様を対象に、IoT技術のプロフェッショナルをお客様企業内に作り出すプロジェクトを開始します。