リバースエンジニアリング
2018年01月12日リバースエンジニアリング Plus
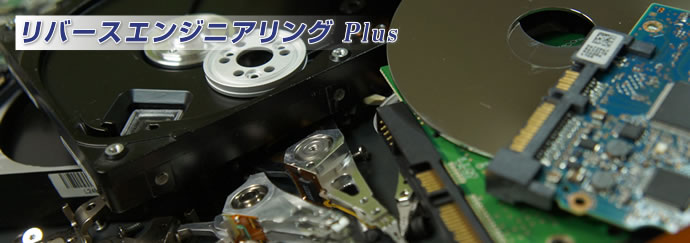
一般的にリバースエンジニアリング(テアダウン)とは、既存の製品を解体・分解して、製品の仕組みや構成部品 、技術要素などを分析する手法のことを言います。この手法により、その製品に使用されている技術を分析、調査、確認することを可能とし、新製品の開発などに役立てることができるものです。
この分野でWTI にご要望いただいているお客様は、⾃動⾞・医療・⻭科・ヘルスケア・産業機器・⺠⽣機器と多岐にわたっております。(リバースエンジニアリングplusの事例はこちら)
WTIのリバースエンジニアリング Plus(テアダウン)受託サービスの特長は2つあります。
- 「解析技術」と「回路技術」の双方を保有している会社ですので、分解して解析するところで終わることなく、設計/開発会社としての知見を生かした受託サービスをご提供できます。
このことにより、世の中にある製品や開発品、試作品を解析して機能を推定し、お客様のご要望をくみ取った形で、新規設計や原理検証等、製品設計に近い領域のご提案まで行える国内でも珍しい設計/開発会社です。- 会社設立以来、日本を代表する多くの大手企業様から、様々な技術分野の設計/開発を受託してきた経験から、高度な技術を豊富に保有しています。他社では難しいとされる製品にも対応させていただいております。
これらの特長から、WTIは以下のようなお客様のご要望に広くお応えしてきております。
- 市場で既に流通している製品から、新製品開発のためのアイデアを得たい。
- 市販品の技術トレンドを調べ、性能改善やコストダウンした製品を開発したい。
- 競合他社が、自分たちの技術を真似していないか、特許侵害していないかを知りたい。
- 自社の製品に改良を加えなければならないが、設計情報が残ってない。なんとか回路図を復元したい。
- 搭載部品が廃番(ディスコン/生産中止)になり、改良設計をしなければならなくなった。自社に回路図が残っていないため、リバースエンジニアリングで回路図を再現し、そこから元のプリント基板までも再現して欲しい。
上記以外にも、WTIは設計開発会社であることを生かして、お客様の様々なご事情に応じた幅広いリバースエンジニアリング(テアダウン)受託サービスをご提供いたします。また、部分的な工程を請け負うことももちろん可能です。
|
|
Wave Technology(WTI)では次のような受託サービスをご提供いたします。
|
サンプル資料
詳細資料をご希望の方はこちら
【当ページ関連の資料タイトル】
●「リバースエンジニアリングサービス紹介」
その他お問い合わせはこちら
リバースエンジニアリング(テアダウン)受託サービス サンプル資料
外観
搭載部品ナンバリング
搭載部品取り外し
研磨後の各レイヤー
搭載部品リストの一部
回路図
その他解析イメージ
<外観>
 |
 |
| TOP | BOTTOM |
<搭載部品ナンバリング>
 |
 |
| TOP | BOTTOM |
<搭載部品取り外し>
 |
 |
| TOP | BOTTOM |
<研磨後の各レイヤー>
 |
 |
| 第1層 | 第2層 |
 |
 |
| 第3層 | 第4層 |
 |
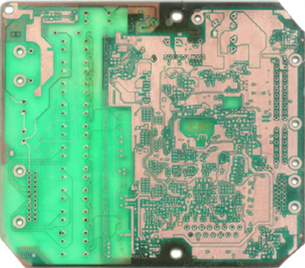 |
| 第5層 | 第6層 |
 |
<搭載部品リストの一部>
| 種類 | 詳細 | 小計 | 合計 |
| 抵抗 | チップ抵抗 | 353 | 379 |
| 金属皮膜 | 26 | ||
| コンデンサ | アルミ電解コンデンサ | 9 | 193 |
| タンタルコンデンサ | 4 | ||
| チップセラミックコンデンサ | 180 | ||
| コイル | コアコイル | 1 | 8 |
| チップ型コイル | 8 | ||
| ホトリレー | 16 | 16 | |
| 水晶振動子 | 1 | 1 | |
| ダイオード | PNダイオード | 32 | 78 |
| ツェナーダイオード | 42 | ||
| Rectifier | 4 | ||
| トランジスタ | バイポーラ | 22 | 26 |
| MOS | 3 | ||
| IGBT | 1 | ||
| IC | マイコン | 1 | 27 |
| その他 | 26 | ||
| コネクタ | 外部接続用コネクタ | 4 | 4 |
部品総数 732
| IC | |||
| 番号 IC | マーキング | 型番等 | 機能 |
| 101 | 5030-EJA 2CE G1409 |
Infineon BTS5030-1EJA |
Smart High-Side Power Switch |
| 102 | LTBVW 4C50 e3 |
LINEAR TECHNOLOGY LT3481 |
36V、2A、2.8MHZ Step-Down Switching Regulator with 50μA Quiescent Current |
| 103 | TJA1042 G7 04 D423 |
NXP TJA1042 |
High-speed CAN transceiver with Standby mode |
| 104 | TJA1042 G7 04 D423 |
NXP TJA1042P |
High-speed CAN transceiver with Standby mode |
| 105 | F JAPAN B91F592BS 419 Z73 SS E1 |
SPANSION MB91590 シリーズ F592BS |
32ビット・マイクロコントローラ FRファミリ FR81S |
| 抵抗 | ||||
| 番号 R | 種類 | サイズ | マーキング | 測定値[Ω] |
| 51 | チップ抵抗 | 1608 | 101 | 100 |
| 52 | チップ抵抗 | 3216 | 473 | 47k |
| 53 | チップ抵抗 | 1005 | 無 | 1k |
| 54 | チップ抵抗 | 1608 | 0 | 0 |
| 55 | チップ抵抗 | 2012 | 472 | 4.7k |
| コンデンサ | ||||
| 番号 C | 種類 | サイズ | マーキング | 測定値[F] |
| 101 | アルミ電解 | 日本ケミコン 4ME | 470 25V | 470μ |
| 102 | アルミ電解 | 日本ケミコン 4FY | 1500 6.3V | 1500μ |
| 103 | チップコンデンサ | 1005 | 無 | 48n |
| 104 | チップコンデンサ | 2012 | 無 | 1n |
| 105 | チップコンデンサ | 1608 | 無 | 98n |
<回路図>
 |
<その他解析イメージ>
 |
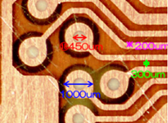 |
 |
| X線解析 | パターン計測 | 断面解析 |
 |
 |
 |
| 電気的特性評価 | 観察 | 機器分解・加工 |
・リバースエンジニアリングのパンフレットはこちら
・外観
・搭載部品ナンバリング
・搭載部品取り外し
・研磨後の各レイヤー
・搭載部品リストの一部
・回路図
・その他解析イメージ
・WTIブログもご覧ください
問合せ急増中!物づくりに欠かせないリバースエンジニアリングって何!?
リバースエンジニアリング プラスワン?
DM第二弾!リバースエンニアリングPlus
WEBからのお問い合わせ件数NO.1はリバースエンジニアリングPlus
おかげさまでお問い合わせ急増!リバースエンジニアリング Plus♪
「リバースエンジニアリング」+「カスタム計測」=「Plusのサービス」!
BOMリストだけのリバースエンジニアリングでも回路設計の会社に依頼がオススメです!
「リバースエンジニアリングPlus」でレポート売りを始めます!
分解調査レポート販売についてご紹介します♪
テクノフロンティア2022に「分解調査レポート販売」を展示しました♪
分解調査(リバースエンジニアリング)のレポート販売はじめました!
・社長ブログもご覧ください
お客様から「『Plus』の意味は何?」のお問合せ相次ぐ