 みなさん、こんにちは
みなさん、こんにちは
高周波デバイス設計課の前田です。
前回のブログでQFP(Quad Flat Package)を例にパッケージの部品や組立工程を紹介しました。今回はその中から“ウエハダイシング”について、もう少し触れてみたいと思います。
■ウエハダイシングとは?
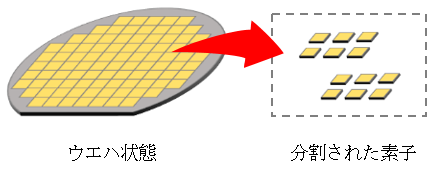 半導体素子はウエハ上に複数形成されていますので、まず初めにウエハを切り分けて各素子を分割しておく必要があります。そして、この分割のことを“ダイシング”といいます。
半導体素子はウエハ上に複数形成されていますので、まず初めにウエハを切り分けて各素子を分割しておく必要があります。そして、この分割のことを“ダイシング”といいます。
ダイシングの方法には、ダイサー方式、レーザー方式、スクライブ方式があります。ここでは比較的に使用される機会が多いダイサー方式の流れをみてみましょう。
■ダイサー方式
ダイサー方式では、高速回転させたダイシングブレード(極薄の円形刃)でウエハを切断します。
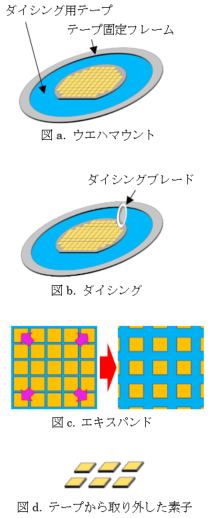 【基本フロー】
【基本フロー】
1. ウエハマウント
分断した素子が飛散しないように、ダイシング用テープの糊面にウエハを貼り付けます(図a)。
2. ダイシング
ダイシングストリート(素子間の切り取り線路)に沿ってダイシングブレードの刃を入れて切断します(図b)。このとき、ウエハとダイシングブレードの摩擦による熱の冷却や切削屑を除去するため、切削箇所に純水を噴射しながら加工します。
3. 洗浄
切断が完了したら、切削屑が残らないように全体を洗い流します。
4. UV(Ultra Violet)照射
ダイシング用テープの糊剤をUV照射で硬化させて、粘着力を低下させます。なお、テープによってはUV照射をせず、粘着性を維持させたままエキスパンドするものもあります。
5. エキスパンド
ダイシング用テープを引き延ばします(図c)。隣接するチップ同士の距離を確保することで、素子を取り外しやすくします。
■求めるのは正確かつ美しい切断面
ダイシング工程で多い不具合として、切断部周辺の欠けや割れがあります。これらを発生させないように加工ストレスを抑え、正確な位置で分割するためにもウエハの材質や厚み、要求品質に応じて、加工方法や治具、切削条件を選定することが大切です。
・・・次回は、分断した素子をパッケージに載せる“ダイボンド”工程に触れたいと思います。
【関連リンク】
WTIメールマガジンの配信(無料)
WTIエンジニアが携わる技術内容や日々の業務に関わる情報などを毎週お届けしているブログ記事は、メールマガジンでも購読できます。ブログのサンプル記事はこちら
WTIメールマガジンの登録・メールアドレス変更・配信停止はこちら

WTIの技術、設備、設計/開発会社の使い方、採用関連など、幅広い内容を動画で解説しています。