 みなさん、こんにちは。第一技術部 高周波デバイス設計課の吉田です。
みなさん、こんにちは。第一技術部 高周波デバイス設計課の吉田です。
はじめまして。どうぞよろしくお願いします。
同じ課のメンバーが、以前のブログ「半導体パッケージの組み立て工程紹介『ウエハダイシング』」でウエハのダイシング(チップ分離)について紹介いたしました。
今回はダイシング方式の種類についてもう少し詳しくご紹介したいと思います。
■ウエハのダイシングとは
ウエハ上に形成された半導体素子を個々のチップに分割することを「ダイシング(チップ分離)」と言います。
1ウエハあたり数百~数万チップの素子を切り出す必要があり 、非常に高い加工精度が要求されます。
一般的なウエハダイシング方法としては、「ブレードダイシング方式」が挙げられますが、ウエハの材質や厚み・デバイス構造に合わせてダイシング方法や加工条件を選定することが重要となってきます。
■ダイシング方式の種類について
ダイシング方式には、使用する工具・装置によって以下のような方式があります。
①ブレードダイシング方式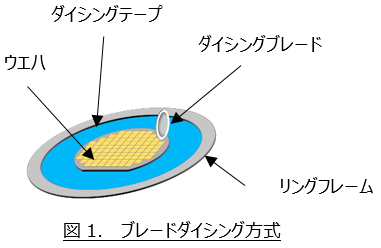
ダイシングテープでリングフレームに貼り付けられたウエハを「ダイシングブレード」と呼ばれる極薄の円形刃を高速で回転させてカットを行う方法です。
ダイシング装置では、加工時に発生するダイシングブレードの熱を冷却するためや、ウエハの切削屑を洗浄するために、切削箇所に純水を掛けながら加工を行います。
加工条件としては、一般的にブレード回転数が数万rpm、切削速度が~100mm/sec程度となります。ウエハの材質、厚み、要求品質に合わせてブレード選定・加工条件・カット方式の選定を行います。
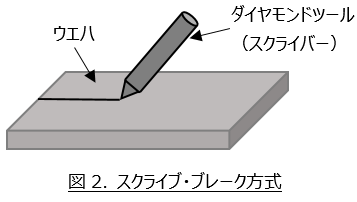 ②スクライブ・ブレーク方式
②スクライブ・ブレーク方式
ウエハ表面にダイヤモンドツールで傷入れ(スクライブ)を行い、傷入れ面の反対側から力を加えて分割(ブレイク)してチップ化する分離方式です。
水を使用しないので、水分を嫌うデバイスで使用されています。
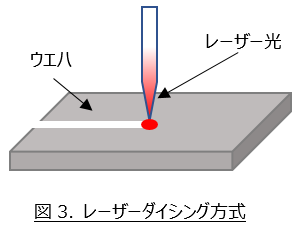 ③レーザーダイシング方式
③レーザーダイシング方式
レーザー光を用いてチップを分離する方式です。
一般的なブレードダイシング方式・スクライブ/ブレイク方式と比べ数倍のスループットが得られ、加工品質向上・歩留向上・ストリー幅の狭小化によるチップ取れ数増加も期待できることから注目されています。
a)レーザーアブレーション方式は、微少なエリアに極短時間にレーザーエネルギーを集中させ、ウエハを昇華・蒸発させて分離する方法です。
b) ステルスダイシング方式は、レーザーでウエハ内部に改質層を形成させブレーキングにてチップを分離する方法です。
加工方法や条件等が不適切だと、チップがカケたり割れたり、信頼性が低下するなどデバイス特性に影響を与える恐れがあるため、ご参考にしていただければ幸いです。
【関連リンク】
WTIメールマガジンの配信(無料)
WTIエンジニアが携わる技術内容や日々の業務に関わる情報などを毎週お届けしているブログ記事は、メールマガジンでも購読できます。ブログのサンプル記事はこちら
WTIメールマガジンの登録・メールアドレス変更・配信停止はこちら

WTIの技術、設備、設計/開発会社の使い方、採用関連など、幅広い内容を動画で解説しています。