 皆さんこんにちは。
皆さんこんにちは。
東京事業所パッケージ設計課の佐々谷です。
2017/6/6に「パッケージって何?」、2017/6/13に「パッケージの種類は多い!」で半導体パッケージの歴史と種類について解説しました。
今回は私のメイン業務であるパッケージの評価・解析の解析について少し触れたいと思います。
(当社の半導体パッケージ評価解析/故障解析サービスはこちら)
パッケージの解析について説明する前にパッケージ形状を久々に思い出していただくため図を掲載します。
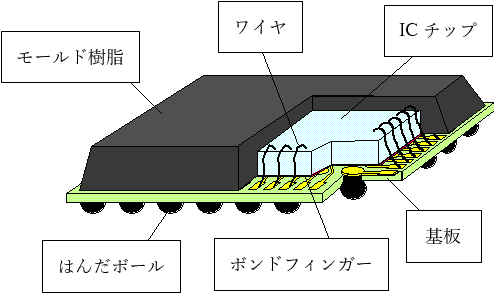
パッケージの解析では単純に電気的に特性が出ているかの確認だけではなく、モールド樹脂にヒビが入っていないか、ワイヤの接合に問題ないか、基板が反っていないかなど、見るべき箇所は多くあります。
上図を見ても解るように眼で見ただけでは見えないものが多く、以前「ワイヤBGAパッケージ」の説明の時にワイヤの太さが0.02mmであると掲載しましたが、もっと細かい箇所を観察することが多いです。
このように私の解析の業務は見えないものをいかに見えるようにするのかがポイントの業務です。一体どういう手法で見えないものを見ていくのか簡単に説明します。
解析の項目としては以下の3種類があります。
- 電気的特性解析
- 非破壊解析
- 破壊解析
これらの解析を進める上では、極力解析のサンプルに傷をつけないように解析していくのもポイントです。
次に各項目を簡単に説明していきます。
1. 電気的特性解析
主に外部端子とICチップの接続異常がないか電気的な視線でパッケージを解析する項目です。
ICチップが正常に動作しているか確認していきます。
※装置・試験
- 専用テスター
- TDR(Time Domain Reflectometry)
- カーブトレーサー
2. 非破壊解析
外観検査、寸法測定など光学的に観察できる部分や、内部を光学的な視覚以外の目でパッケージを観察していく項目です。
超音波、X線を使ってパッケージの表面や内部を透過して剥離やショート傷などを確認していきます。
※装置・試験
- 各種顕微鏡
- 超音波探傷装置(SAT:Scanning Acoustic Tomograph)
- X線観察
3. 破壊解析
確認したい場所を直接パッケージカットしたり、薬品で溶かしたり、強度が保てているか破壊していく項目です。
直接破壊する方法が多く、パッケージが破壊されていくので緊張します。
※装置・試験
- 断面/平面確認
- モールド樹脂開封
- Pull/Shear強度
解析を行う上で上記3項目のうち背景や目的・目標に合った項目を選び、提案し実施するという流れです。私たちの解析では0.001mmにも満たない隙間や亀裂を観察することが多く、パッケージの構造や解析装置の理論が深くわかっていないと失敗する可能性もあります。
このように細心の注意を払い「見えない事を見ようとする解析」に取り組んでいます。そして、日々の精進によってお客様にご満足していただけることを目指しています。
次回のパッケージ設計課のブログでは包装設計についてご紹介する予定です(ご期待ください)。
【関連リンク】
WTIメールマガジンの配信(無料)
WTIエンジニアが携わる技術内容や日々の業務に関わる情報などを毎週お届けしているブログ記事は、メールマガジンでも購読できます。ブログのサンプル記事はこちら
WTIメールマガジンの登録・メールアドレス変更・配信停止はこちら
