半導体パッケージの紹介 第3弾『高機能向けパッケージ』
 皆さんはじめまして。応用機器設計部パッケージ設計課の有田です。
皆さんはじめまして。応用機器設計部パッケージ設計課の有田です。
3ヶ月ほど前に「パッケージって何?」、「パッケージの種類は多い!」のブログを発信した佐々谷さんと同じ課に所属しています。
今回は、半導体パッケージの中でも高機能向けパッケージに分類されるFC-BGA(Flip-Chip Ball Grid Array)にスポットを当てて紹介していきます。
半導体パッケージでは半導体素子(チップ)と外部端子を電気的に接続するための方法としてワイヤボンディング方式、フリップチップボンディング方式及びTAB(Tape Automated Bonding)方式の3種類があります。
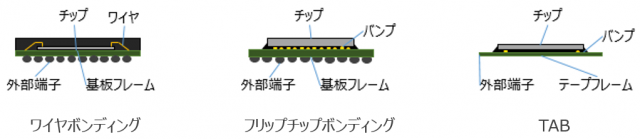
フリップチップボンディング方式は、チップの電極とパッケージ基板上の電極を向かいあわせにバンプを介して接続する方式です。このため、ワイヤボンディング方式の接続と比べて短配線になるのが特徴です。またチップを反転して実装するので、パッケージ上面に電極が無く電極を保護するモールド樹脂も不要です。そのため、発熱源であるチップと放熱フィンなどの放熱部品を直接接触させることで、高い放熱性を確保することが可能になります。
【FC-BGAの特徴】
メリット
①高速信号の規格に適している
- 主要高速信号規格であるDDR3/4、USB3.x、PCI-e3.x、SATA3.0、HDMI2.x、Display-Port1.x等に対応。
- チップ全面にピン配置が可能であり電源/グランドピンを豊富に配置することで、安定した電源供給が可能。
②消費電力が高い製品にマッチしている
- チップがモールド樹脂に覆われていない高放熱構造のため、放熱フィンなどの放熱部品の追加も容易。
デメリット
①高価である
- バンプ接合に対応可能な高精度な基板フレームが必要なため高価になる。
②開発期間が長期化する
- 高性能、多機能が求められるために、開発期間が長期化する。
また、FC-BGAが使用されているLSIの主な用途は、
- スマートフォン
- ノートパソコン/タブレット
- ゲーム機
- カーナビゲーション
- 複写機
などであり、皆さんの身の回りの幅広い製品に使用されています。
以上が高機能向けパッケージFCBGAの概要です。
このFC-BGA開発におけるわれわれの業務は基板フレームの設計と評価・解析になります。
基板設計では上記高速信号を盛り込んだ製品の基板フレーム設計以外にも、USB4やDDR5などの次世代規格の対応に向けた基板設計の検討などもおこなっています。
更にパッケージ製品にあわせたリファレンスボードの設計にも取り組んでいます。
今回ご紹介出来なかったワイヤボンディング方式のBGAについては、第4段でご紹介させていただきます。楽しみにお待ちください。
【関連リンク】
パッケージって何?
パッケージの種類は多い!
WTIメールマガジンの配信(無料)
WTIエンジニアが携わる技術内容や日々の業務に関わる情報などを毎週お届けしているブログ記事は、メールマガジンでも購読できます。ブログのサンプル記事はこちら
WTIメールマガジンの登録・メールアドレス変更・配信停止はこちら
